Correlative imaging workflow available on SEM/FIB

Electron & Ion Microscopy (SEM, FIB and TEM) provides morphological and compositional analysis with ultra high spatial resolution but lack of larger macroscopic context. It is also challenging to obtain analysis and observations with multiple sources from identical locations of the same devices/samples, in order to obtain comprehensive data.
Software solutions are now installed and commissioned in the following microscopes, providing large area imaging and correlative workflow:
ATLAS on Zeiss Sigma FESEM
ATLAS on Zeiss EVO SEM
MAPS on ThermoFisher Hydra Plasma FIB/SEM
These software packages enable automatic workflow of multi-scale (from cm to nm), multi-platform (optical, x-ray, electron and ion microscopy and spectroscopy) and multi-dimensional (2D, 3D and 4D) characterization. Please see the application examples below of how the workflow can provide correlative analysis by linking Optical, Raman, AFM, XRM, SEM, FIB, and TEM data.
ATLAS and MAPS software are now available for user training. If you are interested in utilizing the workflow for your material characterization, please submit a training request on LMACS. If you have any questions, please feel free to contact Shihong Xu (shihongx@ualberta.ca), Josh Perkin (jperkins@ualberta.ca) or Peng Li (peng.li@ualberta.ca).
Application Examples
Sample: Porous Ni film
Application: Large area imaging for multi-scale analysis (Google Earth like images with high spatial resolution)
Instrument: Zeiss Sigma FESEM

Sample: Shale
Application: Multi-scale and correlative SEM/EDX/Raman analysis of elemental and mineral distribution
Instruments:
Zeiss EVO SEM with Oxford EDX
Renishaw inVia Confocal Raman
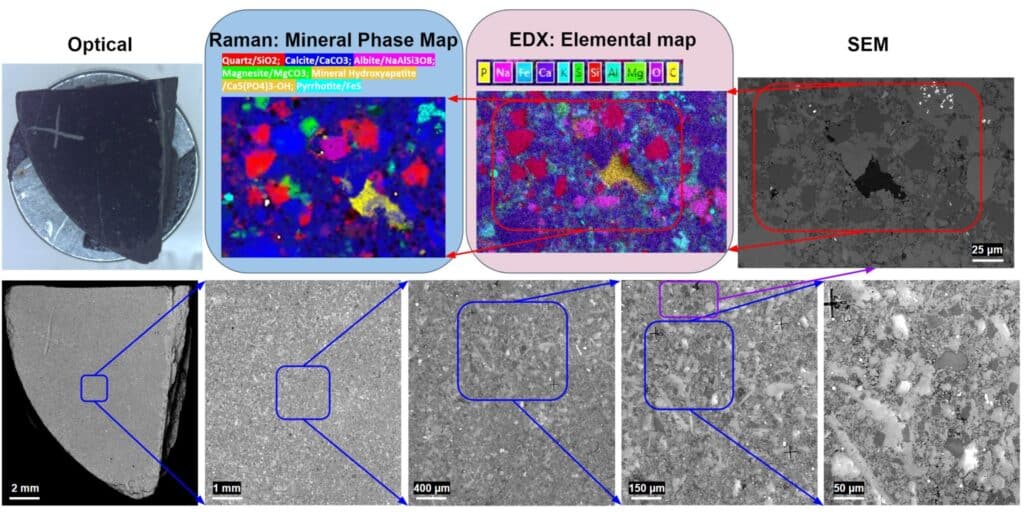
Sample: Mineral inclusions
Application: Multi-scale and correlative SEM/EDX/XRM/TEM analysis of mineral inclusions in magnetite-apatite deposits
This work is published in Geology (2024) 52 (6): 417–422
Instruments:
Zeiss Versa 620 X-Ray Microscope
ThermoFisher Hydra Plasma FIB/SEM
JEOL ARM S/TEM
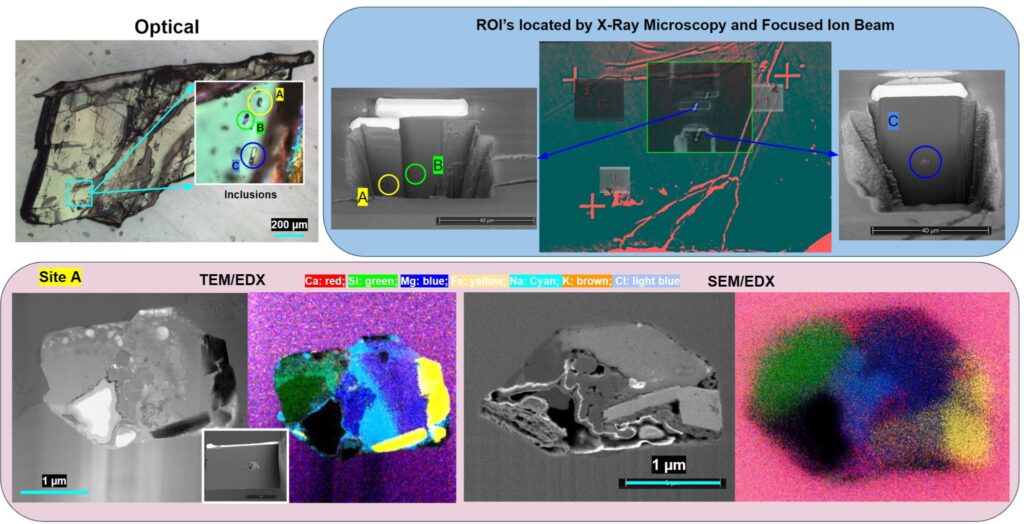
Sample: Multi-layer AlGaAs thin film
Application: Correlative SEM/EDX/AFM/TEM analysis to characterize both surface and cross section morphology and composition
Instruments:
ThermoFisher Hydra Plasma FIB/SEM
Bruker Dimension Edge AFM
JEOL ARM S/TEM