We are glad to announce that Heidelberg’s maskless lithography system MLA150 is open for user training. This dual wavelength exposure tool uses a laser (either 375 nm or 405 nm) to expose patterns from a CAD file onto resist coated samples without the need for a photomask. It’s innovative digital micromirror device (DMD) exposure system allows for 100 mm × 100 mm designs to be exposed in less than 10 min, given proper configuration. The elimination of the photomask fabrication step associated with fast exposure allows for much faster prototyping iterations.

Sample with exposed pattern on AZ1512

MLA150 on site
The main features of this tool are:
- Substrates from 5 × 5 mm² up to 150 × 150 mm² can be directly patterned without the use of photomasks
- Two light sources: 405 nm (for standard g/h/broadband photoresists) and 375 nm (for i-line resists such as SU-8)
- Minimum feature size of 1 µm
- 100 × 100 mm² substrates patterned in less than 10 minutes (405 nm, dose of 100 mJ/cm²)
- Alignment accuracy of 500 nm (topside) / 1 µm (backside)
- Real-time pneumatic and optical auto-focus systems
Additional capabilities:
- Greyscale photolithography (128 grey levels)
- Draw Mode for CAD-less exposure (no design file required)
- High Aspect Ratio Mode, for vertical sidewalls when exposing thick resists
The MLA150 is available to users for self-use (after training) and fee-for-service work. Any users interested in getting trained on this tool should submit a training request via LMACS. If you have any questions, please contact Aaron Hryciw (ahryciw@ualberta.ca) or Gustavo de Oliveira Luiz (deolivei@ualberta.ca).

70 µm SU-8 resist exposed without HAR (Heidelberg qualification)
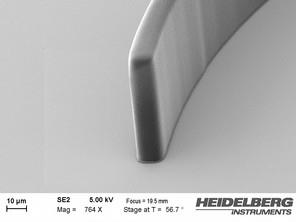
70 µm thick SU-8 exposed with HAR (Heidelberg qualification)